
Accessoires
Pour les échantillons sensibles à l'air, la valise de transfert et la boîte à gants permettent une introduction (XPS et le TOF SIMS) sans pollution extérieure.
TOF SIMS / XPS / HaXPES / Profilométrie
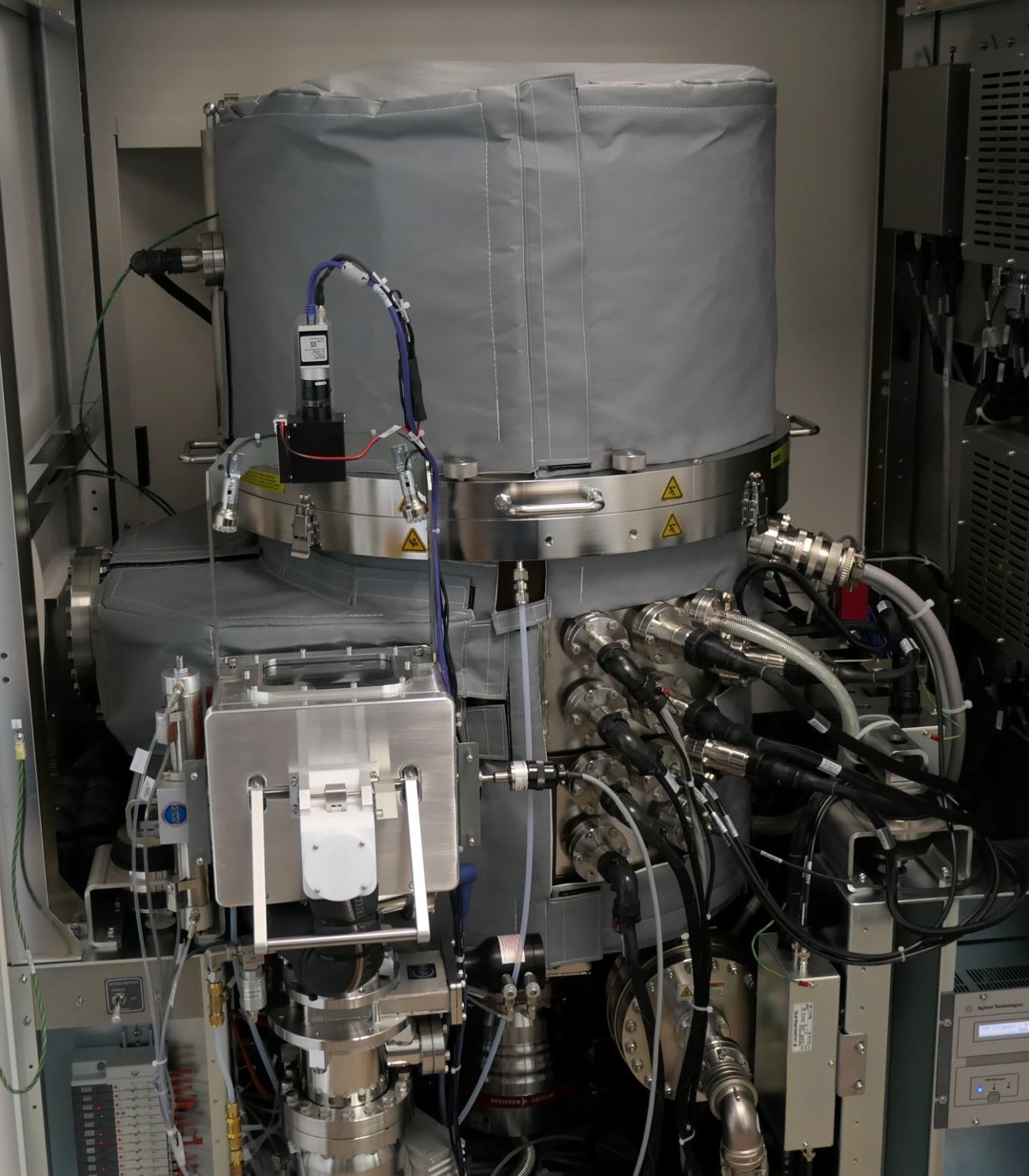
Source Ka1 Cr (5414.9 eV)
Source Ka1 Al (1486.6 eV)
Source d’ions Ar+
XPS/HaXPES résolus en angle
Rotation Zalar
Hot/Cold stage - Polarisation
Environnement chimique
Analyse quantitative
Détection à partir du lithium
Structure électronique

Option faible force 0.03 à 15mg
Pointe diamant 12.5µm à 500nm
Hauteur mesurable à partir de 4 nm
Répétabilité meilleure que 0.6nm
Rugosité 2D/3D
Hauteur de marche

Source Ka1 Al (1486.6 eV)
Source d’électrons (AES)
Source UV (UPS)
Source d’ions Ar+
hello
Four connecté
Valise de transfert
Information chimique/moléculaire
Rapports isotopiques
Détection de tous les éléments
Imagerie, reconstruction 3D

Source Ar+, O2+, Cs+, Bi+, Bi3+
Rotation Zalar
Valise de transfert
Information chimique/moléculaire
Rapports isotopiques
Détection de tous les éléments
Imagerie, reconstruction 3D
Pour les échantillons sensibles à l'air, la valise de transfert et la boîte à gants permettent une introduction (XPS et le TOF SIMS) sans pollution extérieure.